Technology
高速分光エリプソメータ UNECSシリーズの測定事例
測定例(繰返し性は、連続10回取得した測定結果の標準偏差(1σ))
1. 有機EL:Alq3/ガラス 単層膜

4サンプルで膜厚と屈折率を測定し、膜厚は触針式段差計と非常に高い相関が取れます。
| サンプル | A | B | C | D | ||||
|---|---|---|---|---|---|---|---|---|
| 測定対象 | 屈折率 | 膜厚 | 屈折率 | 膜厚 | 屈折率 | 膜厚 | 屈折率 | 膜厚 |
| N | D(nm) | N | D(nm) | N | D(nm) | N | D(nm) | |
| UNECS測定値 | 1.712 | 118.5 | 1.728 | 115.8 | 1.731 | 115.0 | 1.729 | 112.1 |
| 触針式段差計 | - | 118.4 | - | 111.8 | - | 116.1 | - | 109.3 |
2. 薄膜太陽電池:SiO2/μc-Si/ガラス 2層膜

20nm程度のSiO2薄膜も問題なく測定。トータル膜厚(SiO2+μc-Si)では触針式段差計と非常に高い相関が得られます。
| サンプル | A | B | C | ||||||
|---|---|---|---|---|---|---|---|---|---|
| 測定膜 | μc-Si | SiO2 | μc-Si+ SiO2 |
μc-Si | SiO2 | μc-Si+ SiO2 |
μc-Si | SiO2 | μc-Si+ SiO2 |
| UNECS測定値 | 509.9 | 18.2 | 528.1 | 523.2 | 13.8 | 537.0 | 518.8 | 21.7 | 540.4 |
| 触針式段差計 | - | - | 525.4 | - | - | 541.4 | - | - | 546.3 |
3. SiO2単層膜
2nm程度の薄膜でも再現性(繰り返し性)は良好です。

| 計測値 *1) | 繰返し性σ | |
|---|---|---|
| SiO2膜厚 | 1.96 nm | 0.03 nm |
4. レジスト単層膜(膜厚・屈折率同時測定)
2nm程度の薄膜でも再現性(繰り返し性)は良好です。

| 計測値 *1) | 繰返し性σ | |
|---|---|---|
| レジスト膜厚 (設計膜厚50nm) | 50.95 nm | 0.05 nm |
| レジスト屈折率 *2) | 1.576 | 0.02 |
5. レジスト / BARC 2層膜

| 計測値 *1) | 繰返し性σ | |
|---|---|---|
| レジスト膜厚 (設計膜厚50nm) | 48.17 nm | 0.72 nm |
| BARC膜厚(設計膜厚65nm) | 67.16 nm | 0.76 nm |
6. レジスト 3層膜(膜厚・屈折率同時測定)
最上層トップコートの膜厚・屈折率を同時測定しています。

| 計測値 *1) | 繰返し性σ | |
|---|---|---|
| トップコート膜厚 (設計膜厚30nm) | 28.79 nm | 0.05 nm |
| トップコート屈折率 *2) | 1.342 | 0.001 |
7. ALD成膜 HfO2(酸化ハフニウム)極薄膜
測定したウェーハ中心付近のHfO2膜厚(5.85nm、2.46nm)は、TEM(透過型電子顕微鏡)での測定値(6.0nm、2.5nm)とほぼ一致しました。(UNECSの測定信頼性が確認できました)
【測定モデル】
| 膜種 | |
|---|---|
| 最上層 | HfO2 |
| 中間層 | SiO2 |
| 基板 | Siウェーハ |
【測定結果】
| サンプル | 膜厚 | 中心近辺の膜厚 (nm) |
|||
|---|---|---|---|---|---|
| 最大値 (nm) |
最小値 (nm) |
平均値 (nm) |
均一性 (%) |
||
| 5nm Hfo2/自然酸化膜/Si基板 | 6.12 | 5.63 | 5.83 | 4.2% | 5.85 |
| 2nm Hfo2/自然酸化膜/Si基板 | 2.56 | 2.37 | 2.45 | 3.9% | 2.46 |

Technology
-

車載用二次電池の「ヘリウム漏れ試験」導入による効果
-

現場の温室効果ガス排出量を測定するには?カーボンニュートラル実現に向けて「いまを把握する」アルバックの計測技術
-

世界的なヘリウム供給不足!漏れ試験はどうなる? いま注目される「水素漏れ試験」を検討する
-

スマートフォン対応ピラニ真空計SWU10-U
2020年度一般社団法人日本真空工業会表彰 イノベーション賞
(『真空ジャーナル』2022年1月 179号掲載 ) -

独自の空気造形技術に"真空の知恵"をプラスして逆境を切り拓く!!「エアー式簡易陰圧室」
(『真空ジャーナル』2021年7月 177号掲載 ) -

実験動画 | 液体が一瞬で容器に充填される原理
-

ありそうでなかった"真空ポンプメーカーの真空デシケーター"開発ストーリー
-
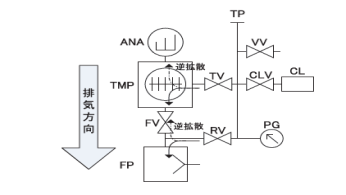
真空装置に必要な漏れ試験技術
-

液体窒素ジェネレーター「EMP シリーズ」の紹介と新製品「UMP-40W」について
-

高速排気と低消費電力を両立したドライ真空ポンプ「LS シリーズ」
-

SWU10-U 特集記事(真空ジャーナル2020年1月 171号掲載)
-

高速分光エリプソメータ UNECSシリーズの測定事例
-
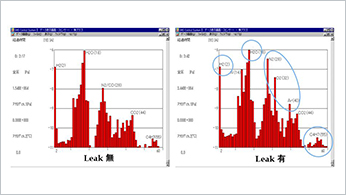
ガス分析計のアプリケーション
-

代替フロン系コールドトラップに替わるヘリウム冷凍機を用いた極低温トラップを発売
-
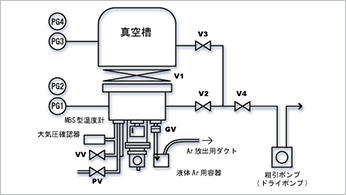
急速低温再生・・・再生時間の短縮
-

スーパートラップの応用と効果的な使用例
-

液体窒素ジェネレータはどこで使用されているの?
-

真空計 ST2 技術レポート
-

液体窒素ジェネレータ - 技術レポート
-

水晶発振式成膜コントローラ・有機材料向け4MHz水晶板の開発
-

HELIOT900 - 技術レポート
-
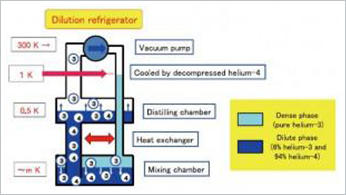
4K 冷凍機を使った無冷媒希釈冷凍機の共同技術




