Technology
真空装置に必要な漏れ試験技術
1.はじめ
半導体などの電子デバイスの製造工程の多くには,真空環境下のプロセスを伴う真空装置が使用されている。その真空装置は,気密性を保つため,製作時やメンテナンス時に定期的な漏れ試験が必要とされている。真空装置に用いられる漏れ試験には,極微小な漏れの検出が必要なことから,ヘリウムガスを使用する試験が広く採用されている。本稿では,その漏れ試験機である,ヘリウムリークディテクタ(helium leak detector, HLD)の原理および試験例について解説する。
2.ヘリウムリークディテクタとは
HLDはヘリウムガスをトレーサーガスとして,HLD内に流入するヘリウムの流量を測定する機器である。トレーサーガスとして,ヘリウムガスが用いられる理由を列挙する。
- 空気中の体積分率が5 ppmと少ないこと。
- 分子直径が最も小さいこと。
- 不活性ガスであること。
- 質量数による識別が容易である。
国内製のHLDは,50年以上前から開発が進められ,基本的な磁場偏向型質量分析の原理を変えることなく,現在においても,もっとも微小な漏れを検出する機器とされている。同じ分析原理であるが,搭載ポンプの数や大きさによって,HLDは,20㎏程度の小型の物から100㎏を超える大型の物も市販されている(図1)。また,漏れ試験の対象となる試験体が複数の場所にあることを想定し可搬性を持たせたHLDや,試験体が大きい時の利便性を考慮し,表示機が本体と独立したHLDもある。
図1 ヘリウムリークディテクタ
HLDによる試験と,その他の試験の測定範囲を表す(図2)。HLDは試験体の内側から外側の漏れ試験(試験体加圧)と試験体の外側から内側の漏れ試験(試験体減圧)の両方が使用できる事も特徴である。
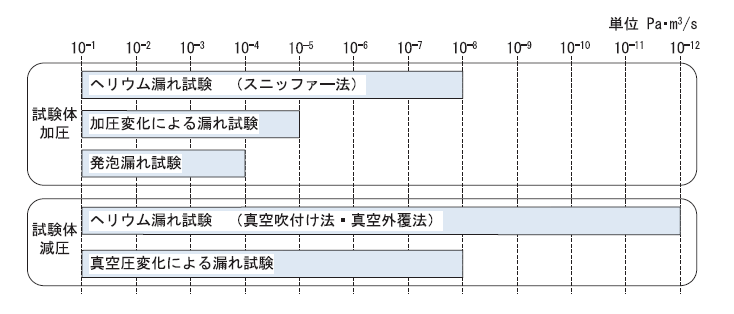
図2 漏れ試験の種類とその測定範囲
図2に記載したHLDの検出下限相当である10-12Pa・㎥/sの漏れは,3.1×10ー4atm・cc/yearに単位換算される。この漏れ量は大気圧下で3.1ccの気体が1万年の年月をかけて流れるという極微小な流量であり,HLDがいかに微小な漏れ試験を扱うかを理解いただきたい。
3.構成と原理
3.1 排気系統
図3は一般的なHLD内部排気系統とその構成機器である。HLD自体もその測定方式から一つの真空装置であり,構成品としても真空機器が多く用いられている。
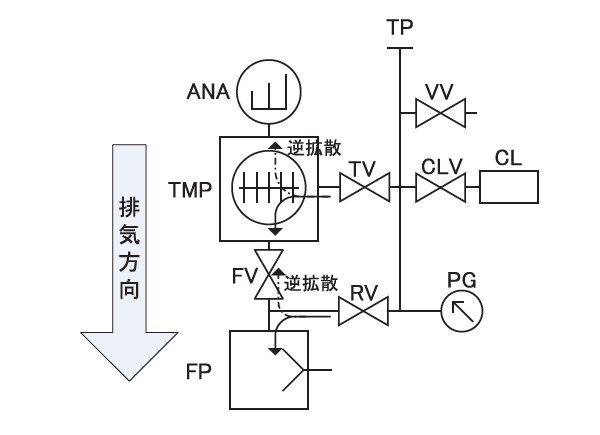
図3 ヘリウムリークディテクタ排気系統図
TP:テストポート(試験体やスニッファープローブを接続するポート),TMP:ターボモレキュラーポンプ(分析管を排気する高真空ポンプ),FP:フォアポンプ(試験体内とTMPを大気圧下から真空排気するポンプ),ANA:分析管(ヘリウムのイオン電流測定),PG:ピラニ真空計(圧力測定),CL:校正リーク(トレーサブルの取れた漏れの発生),TV:テストバルブ,FV:フォアバルブ,RV:粗引バルブ,CLV:校正リークバルブ,VV:ベントバルブ
3.2 カウンターフロー
図3で構成される一般的なHLDの測定開始からの内部動作フローを紹介する。
⑴ HLDの起動完了の後, 試験体をTPに接続,HLDで測定開始を実行する。
⑵ VVとFVが閉じ,RVが開き試験体内を減圧する。
⑶ 試験体内圧力が規定圧力以下になるとFVが開き比較的大きな漏れ(10-8~ 10-3Pa・㎥/s程度)の測定状態となる。
⑷ さらに減圧が進み規定圧力以下になるとRVが閉まりTVが開き微小な漏れ(10-12 ~ 10-5Pa・㎥/s程度)の測定状態となる。
測定の工程である⑶⑷の工程では,TMPとFPの作用により,RVもしくはTVから導入されるガスのうち大部分は実線矢印方向に流れるが,一部のガスは逆拡散して点線矢印方向に流れANAに到達する。TMPはその原理上軽い分子に対しての圧縮比は低く,逆拡散量が多くなるため,軽いガスであるヘリウムは,他のガスに比べ点線矢印方向に流れやすく,ANAに到達しやすいという特徴がある。
このようなTMPの逆拡散現象を利用する測定方式は,「カウンターフロー」と呼ばれ,昨今のHLDに多く採用されている。HLDの機種によりTVを複数設けるなど,ガスの導入口に工夫が見られる。
3.3 分析管
分析管は磁場偏向型の質量分析計となっている(図4)。ヘリウムガスはこの分析管内でヘリウムイオン電流として検知される。分析管内は,ガスイオン飛行軌道確保のため,分子流領域の圧力状態(分子同士の衝突よりも分子と壁の衝突が支配的な状態)が必要である。そのため,分析管内はTMPによる真空排気により,圧力は10-2Pa以下の高真空に保たれている。
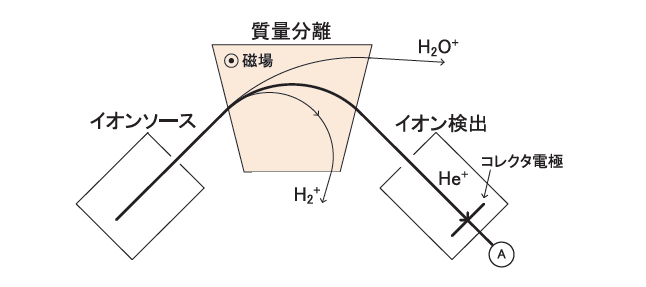
図4 分析菅
3.3.1 イオンソース
ガスをイオン化し,ガスイオンを放出する場所である。イオンソース内の赤熱させたフィラメントから放出された熱電子の衝突を受けたガス分子は,電子が弾かれ正の電荷を持つガスイオンとなる(イオン化)。
ガス分子 → ガスイオン + 電子
M → M+ + e-
ガスイオンは,イオンソース内の電場によってエネルギー(加速電圧Vacc)を得て,イオンソースから質量分離部へ放出される.その他,イオンソースには,熱電子の飛行誘導,ガスイオンビーム収束等を目的とした電極が複数設けられている。
3.3.2 質量分離
ガスイオンを質量分離する場所である。質量分離部には飛行軌道と垂直方向の磁場が設けられている。イオンソースで加速電圧のエネルギーを得たガスイオンは,質量分離部に設けられた磁場Bによってローレンツ力を受け,質量電荷比M/z(質量数Mとイオン価数zの比)によって決まる半径rの円軌道で飛行する(式1)。質量数の小さい水素イオン(M/z =2)などは軌道半径が小さく,質量数の大きい水イオン(M/z=18)などは軌道半径が大きくなり,ヘリウムイオン(M/z=4)のみがイオン検出部に到達する。

式1 ガスイオン軌道半径と質量電荷比の関係
3.3.3 イオン検出
ヘリウムイオンを電流として検出するための電極(コレクタ電極)が設けられている。スリットなどを設け,ヘリウム以外のガスイオンは遮られる。検出されるヘリウムイオン電流は,微小な電流である事から,検出部に増倍器を設ける機器もある。
3.4 校正リーク
校正リークとは,トレーサブルの取れた漏れを発生させる機器である。HLDは漏れ量の測定のため,校正リーク吸引時と非吸引時のヘリウムイオン電流を測定し,ヘリウムイオン電流と漏れ量の関係を与える工程(校正作業)を事前に行う必要がある。
校正リークは2種類の漏れの発生方式がある。チャネル型校正リークは内部の細管から漏れを発生させ,メンブレン型校正リークはガラスや樹脂の透過現象により漏れを発生させる(図5)。一般的に,メンブレン型校正リークの方が,チャネル型校正リークより小さい漏れ量が扱われる。

図5 校正リーク(左:チャネル型,右:メンブレン型)
3.5 制御
初期のHLDは,ヘリウムイオン飛行軌道の調整や,校正リークを用いた校正作業を作業者自身で行う必要があり,取り扱いに熟練が必要な機器であった。しかし,1990年代には,HLD内動作の自動化が進み,近年のHLDは誰でも簡単に漏れ試験ができる機器となっている。さらには,製品の量産設備などに用いられる漏れ試験の自動システムにおいては,上位システムからHLDを制御することで,作業員が直接HLDの操作をすることなく試験を進める事も可能となっている。
4.試験例
4.1 真空容器
真空装置で扱われる真空容器に対しては,試験体の外側から内側への漏れ試験が行われる。試験体内部をHLDで真空に排気,試験体外側にヘリウムガスを吹き付けながら走査する真空吹付け法(JIS Z2331 附属書1)の試験が一般的である(図6)。

図6 真空容器の試験
試験体の溶接部やシール部に欠陥があり漏れが生じていると,試験体外側に吹き付けたヘリウムガスは,試験体内側に流れ込み,真空空間で拡散され,HLDに到達し検出される。ヘリウムガス吹付けからHLDに検出されるまでの応答時間は,漏れ流路の形状,試験体の形状や内容積,HLDの排気速度等に依存し,注意が必要である。応答時間を試験体の内容積VをHLDの排気速度Sで除した,真空排気の時定数V/Sを目安と考える簡易的な方法もあるが,試験体に校正リークを接続しての確認を推奨する。
また,試験体の減圧時間短縮のため,HLDと並列で真空ポンプを設ける試験方法がある。この方法は,試験体に漏れ込んだヘリウムガスのすべてがHLDに流れ込まないため,実際の漏れ量は,HLDの測定漏れ量よりも大きい事に注意が必要である。
4.2 加圧容器
HLDでは,専用のプローブを接続する事で,スニッファー法(JIS Z 2331 附属書3)による試験体の内側から外側への漏れ試験を行うこともできる。スニッファー法では,漏れ量単位以外に,ヘリウム濃度単位ppmによる試験も可能となる。
図7は,配管継手部に対してHLDを用いたスニッファー法の試験を行っている様子である。配管内にヘリウムガスを加圧させ,試験箇所である継手部にスニッファープローブを近づけ,ガスを吸引しヘリウムガスの漏れ出しの有無を確認する。

図7 スニッファー法による配管試験例
昨今,HLDによる漏れ試験は,微小漏れの検出,漏れ量の定量,試験時間短縮,乾燥工程不要などの理由で,真空装置に限らず,自動車部品,空調冷凍機部品,食品・医療品の梱包関連品,さらには原子力関連に及ぶまでその使用範囲は広くなっている。本稿を通じて,漏れ試験に関わる方々の理解や運用の参考になれば幸いである。
参考文献
1 )一般社団法人日本非破壊検査協会:漏れ試験Ⅰ,Ⅱ
2 )ULVAC TECHNICAL JOURNAL No.79 p.14-18(2015)
転載:日本フルードパワーシステム学会誌
2020年7月発行 第51巻 第4号 P.21~P.23
Technology
-

アルバックのヘリウムリークテスト装置
-

車載用二次電池の「ヘリウム漏れ試験」導入による効果
-

現場の温室効果ガス排出量を測定するには?カーボンニュートラル実現に向けて「いまを把握する」アルバックの計測技術
-

世界的なヘリウム供給不足!漏れ試験はどうなる? いま注目される「水素漏れ試験」を検討する
-

スマートフォン対応ピラニ真空計SWU10-U
2020年度一般社団法人日本真空工業会表彰 イノベーション賞
(『真空ジャーナル』2022年1月 179号掲載 ) -

独自の空気造形技術に"真空の知恵"をプラスして逆境を切り拓く!!「エアー式簡易陰圧室」
(『真空ジャーナル』2021年7月 177号掲載 ) -

実験動画 | 液体が一瞬で容器に充填される原理
-

ありそうでなかった"真空ポンプメーカーの真空デシケーター"開発ストーリー
-
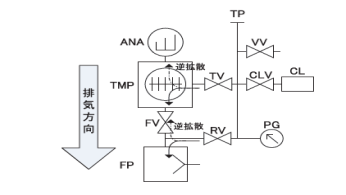
真空装置に必要な漏れ試験技術
-

液体窒素ジェネレーター「EMP シリーズ」の紹介と新製品「UMP-40W」について
-

高速排気と低消費電力を両立したドライ真空ポンプ「LS シリーズ」
-

SWU10-U 特集記事(真空ジャーナル2020年1月 171号掲載)
-
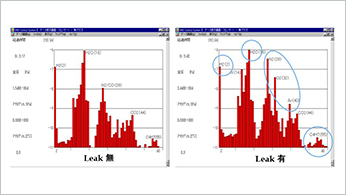
ガス分析計のアプリケーション
-

代替フロン系コールドトラップに替わるヘリウム冷凍機を用いた極低温トラップを発売
-
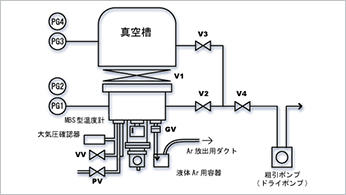
急速低温再生・・・再生時間の短縮
-

スーパートラップの応用と効果的な使用例
-

液体窒素ジェネレータはどこで使用されているの?
-

真空計 ST2 技術レポート
-

液体窒素ジェネレータ - 技術レポート
-

水晶発振式成膜コントローラ・有機材料向け4MHz水晶板の開発
-

HELIOT900 - 技術レポート
-
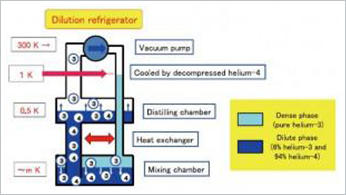
4K 冷凍機を使った無冷媒希釈冷凍機の共同技術